TSV 조립을 위한 혁신적인 구리 전도기술 개발 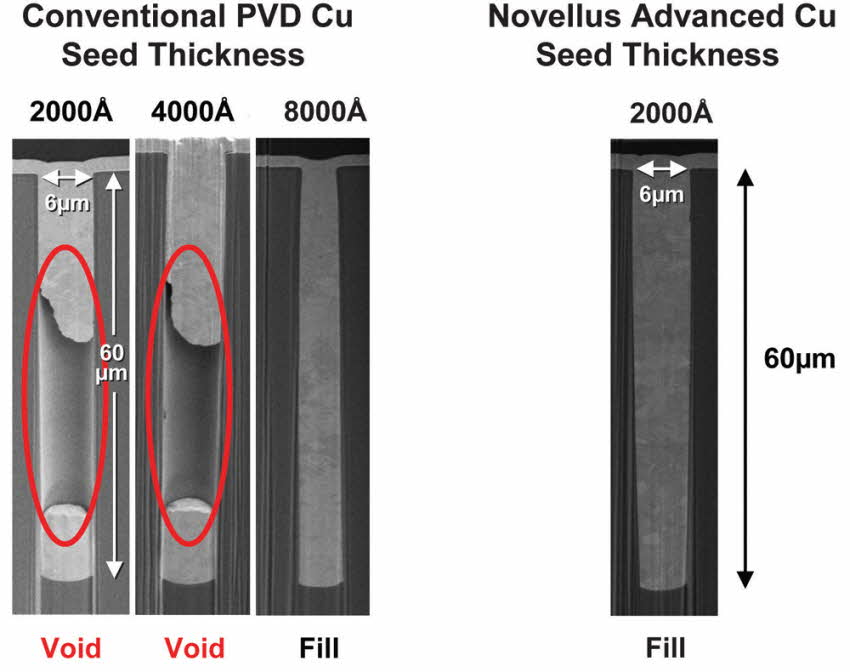
노벨러스 시스템은 신흥TSV 조립 시장을 겨냥한 진보한 새로운 구리 절연/전도 물리적 증기 증착 공정을 발표했다. 새롭게 발표한 구리 절연/전도 PVD 공정은 특허를 받은 HCM 기술과 함께 양산화가 검증된 INOVA짋 플랫을 사용해 TSV 애플리케이션을 위한 전통적인 PVD 전도 공정보다 두께가 4배 더 얇은 매우 균일한 구리 전도막을 생산할 수 있다. HCM TSV 공정은 우수한 측벽 및 바닥 두께를 산출하고, 후속 TSV 전기 도금 단계에서 보이드 없이 구리를 채울 수 있다.
기존의 2D, 핀 기반 칩 조립 방식과 대조적으로, TSV 는 다수의 칩들이 서로의 상부에 적층 되어 공간을 절약 할 수 있는 3D 조립을 할 수 있다. 3D로 적층 된 칩들은 짧은 TSV구리배선에 의해 서로 연결되어 있어 소자의 구동 속도를 증가시키고, 전력 소모를 줄인다.
TSV 구리 배선은 하나의 칩에 다른 하나를 연결하는 “Pillars”를 만들기 위해 전기 도금 구리 증착이 뒤 따르는 PVD구리 절연/전도막의 보편적인 상감증착 방식을 활용한다. 전통적인 듀얼 상감 구리 배선 구조에서 보면 TSV 구조는 극단적으로 깊어 어떤 경우는 그 깊이가 200 마이크론 이나 된다. 고 종횡비 구조는 균일한 전도층의 증착을 어렵게 만든다. 균일하지 못한 구리 전도층은 최소한의 측벽 두께로, 후속의 구리 TSV 매립 단계에서 보이드 형성을 유발할 수 있고, 소자의 신뢰성에 직접적인 영향을 미칠 수 있다.
<저작권자(c)스마트앤컴퍼니. 무단전재-재배포금지>
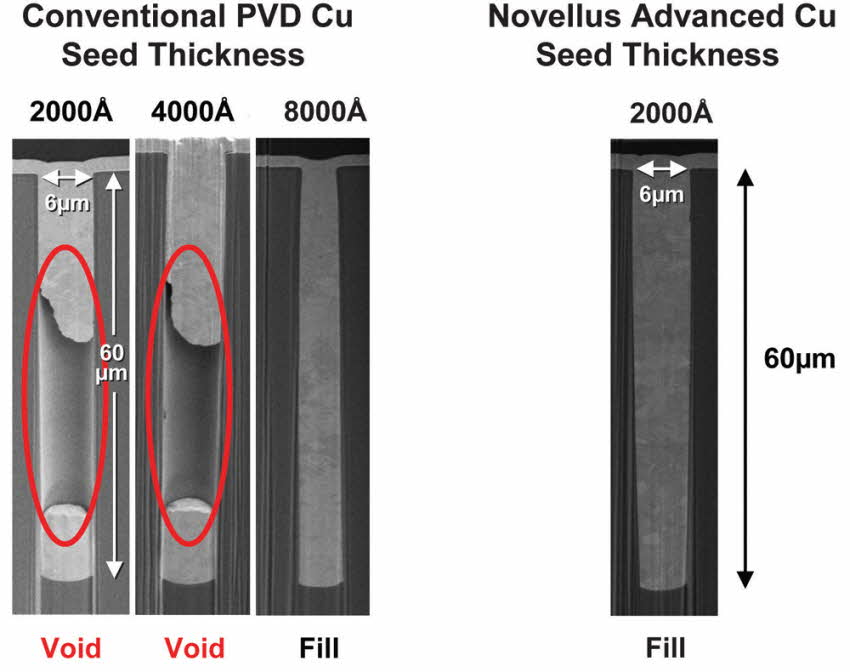 노벨러스 시스템은 신흥TSV 조립 시장을 겨냥한 진보한 새로운 구리 절연/전도 물리적 증기 증착 공정을 발표했다. 새롭게 발표한 구리 절연/전도 PVD 공정은 특허를 받은 HCM 기술과 함께 양산화가 검증된 INOVA짋 플랫을 사용해 TSV 애플리케이션을 위한 전통적인 PVD 전도 공정보다 두께가 4배 더 얇은 매우 균일한 구리 전도막을 생산할 수 있다. HCM TSV 공정은 우수한 측벽 및 바닥 두께를 산출하고, 후속 TSV 전기 도금 단계에서 보이드 없이 구리를 채울 수 있다.
노벨러스 시스템은 신흥TSV 조립 시장을 겨냥한 진보한 새로운 구리 절연/전도 물리적 증기 증착 공정을 발표했다. 새롭게 발표한 구리 절연/전도 PVD 공정은 특허를 받은 HCM 기술과 함께 양산화가 검증된 INOVA짋 플랫을 사용해 TSV 애플리케이션을 위한 전통적인 PVD 전도 공정보다 두께가 4배 더 얇은 매우 균일한 구리 전도막을 생산할 수 있다. HCM TSV 공정은 우수한 측벽 및 바닥 두께를 산출하고, 후속 TSV 전기 도금 단계에서 보이드 없이 구리를 채울 수 있다.